微小デバイスの内部を調べるEDMR
微小なデバイスの内部は通常のESRでは感度が足りなくて調べることができないため、どのような欠陥がどこに発生しているのか、まだよく分かっていないことが沢山あります。私たちは電流検出型のESR(Electrically Detected Magnetic Resonance、通称EDMR)を使って、微小なデバイスの内部を調べています。
EDMRの応用例を紹介します。超低消費電力のDRAM(Dynamic RAM)の開発です。DRAMは「揮発性メモリ」と言って、記憶動作に電力を必要とするため、大容量メモリを搭載するサーバーやハイエンドコンピュータの消費電力を大きくしたり、モバイル機器に搭載できるメモリ容量が限られるといった問題を抱えています。揮発性の原因はシリコンMOS型トランジスタに発生した結晶欠陥です。
私たちは、0.1μmサイズのトランジスタをEDMRで観察して、シリコン空孔と酸素原子が結びついた「VO欠陥」が原因になっていることを突き止めました(図4)。このような微細デバイス中の結晶欠陥は「VRT」のような不思議な現象も引き起こします(図5)。
私たちはEDMRを使って、シリコンLSIに秘められている未知の現象を解析していきたいと考えています。欠陥を上手にコントロールすることができれば、こういったメモリの性能(特に低消費電力性能)はまだまだ向上すると考えられます。
 |
| 図4 DRAMのデータ保持時間延長に貢献したEDMR |
| EDMRでDRAMの記憶セルを調べたところ、記憶セルのトランジスタに「VO欠陥」という結晶欠陥が発生しており、これがリーク電流の原因(データ揮発 性の原因)になっていることが分かりました。この欠陥は元々はCZタイプのシリコン単結晶で発見された結晶欠陥で、概ね200~300℃の熱処理で消失す ることが報告されています。しかし、微細に作り込まれたシリコントランジスタの中では1000℃を超えるような熱処理の後でもVO欠陥が生き残ることがあ ります。この欠陥をコントロールすることによって、DRAMのデータ保持時間の大幅延長が実現しました。【日刊工業新聞2006年3月30日】 |
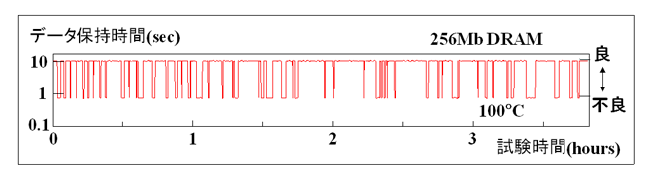 |
| 図5 DRAMで見られる1個の結晶欠陥の影響(VRT現象) |
| 図4で述べたような結晶欠陥は、たった1個でもデバイスの特性を大きく変えてしまうことがあります。この例は「Variable Retention Time(VRT)現象」と呼ばれるもので、DRAMのデータ保持時間がたった1個の結晶欠陥によって大きく変動する現象です。このような現象をコント ロールすることがDRAMの低消費電力化に大きく関わってきます。【梅田:応用物理 76, 1037-1040 (2007).】 |
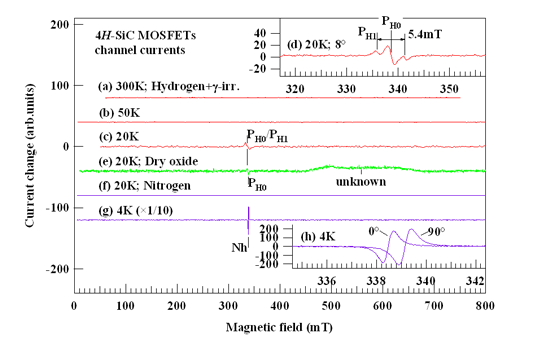 |
| 図6 SiCのMOS界面欠陥 |
| シリコンカーバイド(SiC)は、シリコンと同様のMOS(Metal-Oxide-Semiconductor)型の電界効果トランジスタ (MOSFET)を作ることができる優れた半導体です。しかし、SiCのMOSFETの性能は、現状では「MOS界面欠陥」によって大幅に悪化してしまいま す。私たちは極低温EDMRを使って、SiC-MOS界面に炭素ダングリングボンド型の界面欠陥が存在すること、それが浅い界面準位を発生させてチャネル移動度に影響を与えること、これらの欠陥が界面処理で大きく変 化することを突き止めました。【T. Umeda et al., ECSCRM 2010 (Oslo ,Norway, Aug. 30 - Sep. 4, 2010).】 |
[Page top]