4H-SiC MOS界面に関する研究
現在主流であるシリコン(Si)半導体に代わる材料として炭化ケイ素(SiC)が盛んに研究されています。SiCパワーデバイスは、SiC/SiO2界面に存在する大量の界面欠陥がその性能向上を妨げてることが分かっています。私たちはその界面欠陥を同定するために、前述の電子スピン共鳴分光法、電流検出電子スピン共鳴分光法をSiC/SiO2界面に適用しています。
SiCはSi面が標準的にチャネルとして用いられています。Si面4H-SiC MOSFET(Metal Oxide Semiconductor Field-Effect Transistor)は、ドライ酸化によってゲート絶縁膜を作製しますが、SiC/SiO2界面に界面準位が大量に存在し、電界効果移動度向上の妨げとなっています。そのため、標準的には界面窒化処理が行われ、界面準位密度を低減させ、電界効果移動度を向上させます。
ドライ酸化4H-SiC/SiO2界面では「PbCセンター」と呼ばれる炭素(C)ダングリングボンドが電子スピン共鳴分光法、電流検出電子スピン共鳴分光法によって同定されました(図9)。また、窒化処理を行ったMOSFETからは、「Kセンター」、「incomplete Kセンター」と呼ばれるCが窒素(N)に置換された界面欠陥が電流検出電子スピン共鳴分光法によって同定されました(図10)。また、Si面よりも高い移動度が期待されるa,m面を用いたMOSFETに対しても世界で初めてEDMR信号を観測しました(図11)。
 |
| 図9 Si面ドライ酸化4H-SiC/SiO2に大量に存在する「PbCセンター」 |
| Si面ドライ酸化4H-SiC/SiO2界面に電子スピン共鳴分光、および電流検出電子スピン共鳴分光を適用することで炭素のダングリングボンドである「PbCセンター」が同定されました。これはSi/SiO2においてすでに同定されている「Pbセンター」と呼ばれるSiダングリングボンドに非常に類似した欠陥であることわかりました。【T. Umeda et al., Appl. Phys. Lett. 116, 071604 (2020).】 |
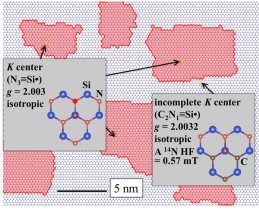 |
| 図10 窒化されたSi面4H-SiC/SiO2界面に発生する「Kセンター」と「incomplete Kセンター」 |
| Si面nチャネル4H-SiC MOSFETは界面窒化によって界面準位密度が低減し、移動度が向上することが知れれている。窒化処理後のSi面4H-SiC MOSFETに対して電流検出電子スピン共鳴分光法を適用することで「Kセンター」と「incomplete Kセンター」の2種類の界面欠陥が同定されました。これらは炭素が窒素に置換された界面欠陥であることがわかりました。【E. Higa, et al, Appl. Phys. Lett. 116, 171602 (2020).】 |
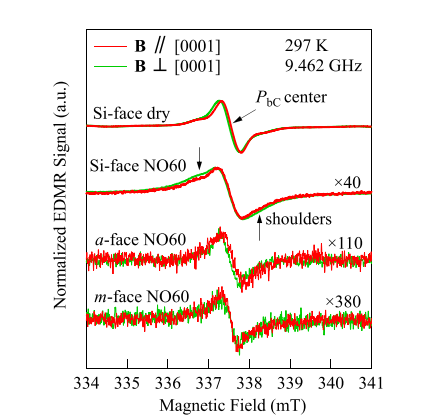 |
| 図11 a, m面4H-SiC MOSFETに対する電流検出電子スピン共鳴分光法 |
| 世界で初めてa, m面4H-SiC MOSFETに対して電流検出電子スピン共鳴分光法を適用し、強度は不十分ながらも信号を観測することができました。【E. Higa, et al, Appl. Phys. Lett. 116, 171602 (2020).】 |
[Page top]